基本信息
濃度界層隨著ULSI技術的不斷向前發展,對
半導體矽的表面性質要求也越來越嚴格。而且電路的集成度日益提高,單元圖形的尺寸日益微化,污染物對器件的影響也愈加突出,以至於潔淨表面的製備已成為製作64M和256MbyteDRAM的關鍵技術[1,2]。此外有超過50%成品損失率是由矽表面的污染所造成的。
 濃度界層
濃度界層介紹
濃度界層矽片上的雜質一般可分為三種:分子型、離子型和原子型。這裡主要探討原子型雜質。原子型雜質主要是指過渡金屬或貴金屬原子(如Au、Ag、Cu等),它們主要來自於矽的酸性刻蝕劑中。原子型雜質主要影響器件中少子壽命、表面的導電性、門氧化物的完整性和其它器件穩定性參數等,特別在高溫或電場下,它們能夠向半導體結構的本體擴散或在表面擴大分布,導致器件性能下降,產率降低。在工業上,矽表面清洗分為乾法和濕法清洗兩種,前者是物理方法,後者是化學方法。目前濕法清洗一直占主導地位,因為它對雜質和基體選擇性好,可將雜質清洗至非常低的水平。本文綜述了幾種典型金屬在濕法清洗過程中對矽片表面產生的金屬微觀污染和所涉及的機理研究進展,並討論了今後該領域的研究方向。
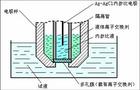 濃度界層
濃度界層研究
半導體微電子製造過程中,金屬污染濃度可達到1012~1013atom/cm2。但實際上製造16MbyteDRAM要求必須將矽表面金屬濃度降低到1×1012atom/cm2以下。所以研究化學試劑HF中金屬離子(主要是銅離子)在矽表面的沉積行為和污染機理具有重要的科學價值和實際意義。
大量研究表明,在HF介質中,溶液中微量的Ag+、Cu2+、Au3+、Pt2+、Pd2+等貴金屬/過渡金屬離子均以電化學還原方式沉積在無氧化物的矽片表面,但其沉積機理尚未達成共識。對銅而言,一般認為來自DHF溶液中的Cu2+通過氧化還原得到電子而以Cu金屬的形式沉積在Si表面,而矽在DHF溶液中的溶解則釋放出電子。
 濃度界層
濃度界層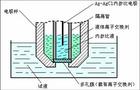 濃度界層
濃度界層
