APT是一個程式開發語言,Automatic Test Pattern Generation(ATPG)自動測試向量生成是在半導體電器測試中使用的測試圖形向量由程式自動生成的過程。測試向量按順序地載入到器件的輸入腳上,輸出的信號被收集並與預算好的測試向量相比較從而判斷測試的結果。ATPG有效性是衡量測試錯誤覆蓋率的重要指標。
基本介紹
- 外文名:Automatic Test Pattern Generation(ATPG
- 簡稱:ATPG
- 周期:測試的生成、測試的套用
- 屬性:程式開發語言
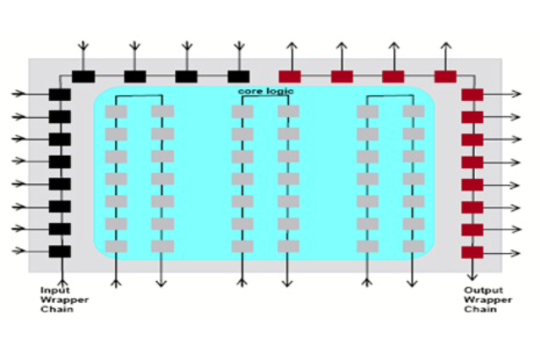
APT是一個程式開發語言,Automatic Test Pattern Generation(ATPG)自動測試向量生成是在半導體電器測試中使用的測試圖形向量由程式自動生成的過程。測試向量按順序地載入到器件的輸入腳上,輸出的信號被收集並與預算好的測試向量相比較從而判斷測試的結果。ATPG有效性是衡量測試錯誤覆蓋率的重要指標。
APT是一個程式開發語言,Automatic Test Pattern Generation(ATPG)自動測試向量生成是在半導體電器測試中使用的測試圖形向量由程式自動生成的過程。測試向量按順序地載入...
3.6 基於ATPG工具的故障模擬3.6.1 實驗工具和目的3.6.2 Tetramax的故障模擬流程3.6.3 腳本檔案舉例3.6.4 練習1——故障模擬3.6.5 練習2——ATPG工具參數設定本...
13.3 使用TetraMAX進行ATPG生成 34413.3.1 TetraMAX的圖形界面 34413.3.2 TetraMAX的基本流程 34513.3.3 ATPG測試向量生成 34613.4 DFT設計實例 348...
為SoC設備所做的逐塊測試規劃必須實現:正確配置用於邏輯測試的ATPG工具;測試時間短;新型高速故障模型以及多種記憶體或小型陣列測試。對生產線而言,診斷方法不僅要找到...
5.1 時序ATPG方法與故障的分類5.2 故障壓縮5.3 故障模擬5.4 同步電路的測試生成5.5 異步電路的測試生成5.6 測試壓縮小結補充閱讀材料...
測試碼自動生成(automatic test pattern generation , ATPG)是指數字電路中,針對確定的故障模型和電路,可以建立該電路故障表,對於故障表中的每一故障,通過某種算法(...
