結深是影響光伏器件性能好壞的重要參數。定義為從矽中表面到擴散層濃度等於襯底濃度處之間的距離,一般以微米為單位計量。
基本介紹
- 中文名:結深
- 外文名:junction depth
- 測量方法:化學染色法為主
- 領域:光伏體晶片製造
- 類別:光伏器件重要參數
- 計量單位:微米
定義,結深測量,化學染色法,光波干涉測量方法,相關研究,
定義
結深是半導體器件製造工藝的重要參數之一。結深是指在矽片中摻入不同導電類型的雜質時,在距離矽片表面xf的地方,摻入的雜質濃度與矽片的本體雜質濃度相等,即在這一位置形成了PN結。xf被稱為結深。
結深測量
傳統的結深測試方法有:汞探針電容法、擴展電阻法、染色SEM法等。
結深的測量,通常在100ml HF(49%)加幾滴HNO3的混合液中對磨斜角(1°~5°)的樣品做化學染色,有時只要HF就夠了。如果樣品置於強光下照一兩分鐘,P型區要比n型區染色重。利用Tolansky干涉條紋技術,可精確測量0.5~100μm的結深。


化學染色法
採取化學染色法對B,Al和P雜質擴散形成的結深進行檢測,通過實驗不同濃度染色液的腐蝕特性,選擇易於控制和重複性好的染色腐蝕液。同時採用擴展電阻法對同一個樣品的結深進行測試,以擴展電阻法所得結果為標準,與染色法的測量結果進行對比,根據測試結果與理論分析,對染色法的測試結果進行修正,確定P擴散結深的測試係數。
光波干涉測量方法
利用光波干涉原理及其測量效應,可以測量半導體晶片的結深。方法如下:被測晶片結深區磨角染角,顯示結深。把晶片放到干涉顯微鏡上成像,使晶片表面和磨角區同時出現在顯微鏡視野中。此時磨角區是一斜面,於是干涉條紋也相應發生變化,在界面處彎折。調整干涉顯微鏡,使片面區干涉條紋垂直於磨角區界面。
選擇一條正好和結深點交會的干涉條紋,用干涉顯微鏡的讀數機構測出這條幹涉條紋的彎曲量a,再測出干涉條紋的寬度b,用公式即可求出結深。
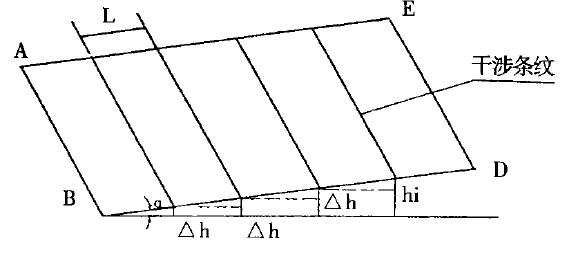
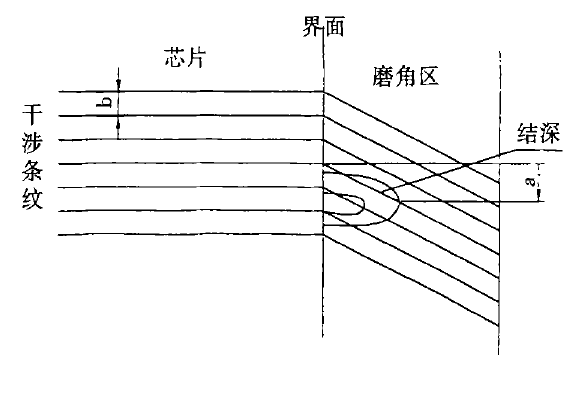
相關研究
光回響度是InGaAs/InP探測器的一個重要參數,它表征了探測器將入射光轉換為光電流信號的強弱程度。光回響度小,說明探測器轉換能力弱,探測靈敏度低,將影響到探測器的探測性能。
莊四祥等人研究了InGaAs/InP PIN探測器中擴散結深對光回響度的影響,對不同擴散條件下的光電探測器進行了對比實驗,測量了不同結深下器件的I-V特性和光回響度。結果表明:擴散結深對器件的I-V特性影響不大,而對光回響度影響很大,當結深處在InGaAs吸收層上表面時,光回響度最大值出現在波長1.55μm處;而當結深進入襯底InP層後,光回響度最大值則出現在波長1μm處。另外,在閉管擴散實驗中,嚴格控制溫度和擴散時間是控制結深的關鍵,研究了不同擴散溫度和擴散時間下的結深,為器件的製備提供了參考。
光回響度隨不同的P-N結結深變化而變化。

