在積體電路生產中,先使用光刻(L)和刻蝕(E)形成一維的線條,然後再使用另一次光刻和刻蝕對一維線條進行切割,實現所需要的圖形的工藝,稱為光刻刻蝕切割工藝(LE+Cut)。
基本介紹
- 中文名:光刻刻蝕切割工藝
- 外文名:LE+Cut
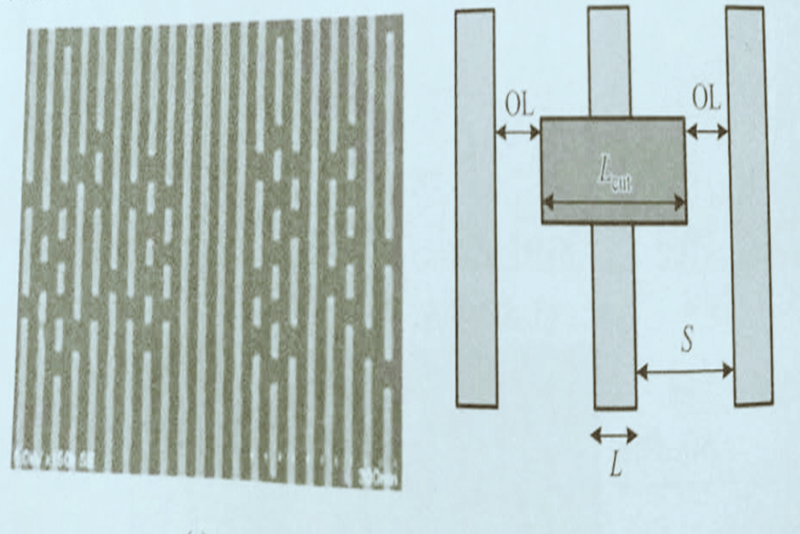
在積體電路生產中,先使用光刻(L)和刻蝕(E)形成一維的線條,然後再使用另一次光刻和刻蝕對一維線條進行切割,實現所需要的圖形的工藝,稱為光刻刻蝕切割工藝(LE+Cut)。
在積體電路生產中,先使用光刻(L)和刻蝕(E)形成一維的線條,然後再使用另一次光刻和刻蝕對一維線條進行切割,實現所需要的圖形的工藝,稱為光刻刻蝕切割工藝(LE+Cut)。工藝簡介光刻刻蝕切割工藝(LE+Cut)比較適用於...
光刻流程 一般的光刻工藝要經歷矽片表面清洗烘乾、塗底、旋塗光刻膠、軟烘、對準曝光、後烘、顯影、硬烘、刻蝕、檢測等工序。矽片清洗烘乾 方法:濕法清洗+去離子水沖洗+脫水烘焙(熱板150~250C,1~2分鐘,氮氣保護)目的:a、除去...
《衍射極限附近的光刻工藝》是2020年2月清華大學出版社出版的圖書,作者是伍強。內容簡介 為了應對我國在積體電路領域,尤其是光刻技術方面嚴重落後於已開發國家的局面,破解光刻製造設備、材料和光學鄰近效應修正軟體幾乎完全依賴進口的困境,作為...
《高分辨、高縱寬比光刻材料與刻蝕技術的研究》是依託清華大學,由洪嘯吟擔任項目負責人的面上項目。項目摘要 床面泥沙上揚的定量化是解決泥沙運動力學及其工程套用領域若干基本問題的一大障礙。已有方法強裂依賴於經驗,局限性明顯。湍流...
本教材主要供高等院校微電子相關專業的高年級本科生或大專生習,也可以作為從事積體電路工藝工作的工程技術人員自學或進修的參考書。簡要介紹了半導體器件基本結構 、重點介紹了包括清洗、氧化、化學氣相澱積、金屬化、光刻、刻蝕、摻雜、平坦...
3.3.3650nm共振腔LED晶片工藝 參考文獻 第4章LED晶片結構及製備工藝 4.1晶片製造基礎工藝 4.1.1蒸鍍工藝 4.1.2光刻工藝 4.1.3刻蝕工藝 4.1.4沉積工藝 4.1.5退火工藝 4.1.6研磨拋光工藝 4.1.7點測工藝 4.1.8檢驗...
5、如權利要求2所述的具有低深寬比通孔的圓片級氣密性封裝工藝,其特徵是:利用濺射、光刻、電鍍、刻蝕工藝在蓋子圓片上形成引線、壓焊塊、密封環、焊盤。6、如權利要求2所述的具有低深寬比通孔的圓片級氣密性封裝工藝,其特徵是:...
雷射加工作為雷射系統最常用的套用,主要技術包括雷射焊接、雷射切割、表面改性、雷射打標、雷射鑽孔、微加工及光化學沉積、立體光刻、雷射刻蝕等。雷射加工設備就是利用雷射加工技術改造傳統製造業的關鍵技術設備之一,主要產品則包括各類雷射打...
“CUT”裁剪工藝一般用於規則線條結構的裁剪,特別是鰭形結構和柵極結構,使用一個或多個裁剪掩模實現對線條結構的精細裁剪;“BLK”裁剪工藝一般用於凹槽結構的裁剪,例如金屬結構,在凹槽轉移刻蝕之前,使用掩模將某些結構覆蓋,實現對凹槽...
優選地,所述所述刻蝕的方法包括但不限於下列方法中的一種:濕法刻蝕,ICP刻蝕,RIE刻蝕。優選地,所述劃片切割的切割方法包括但不限於下列方法中的一種:雷射劃片,機械劃片。《一種垂直結構的白光LED晶片及其製造方法》所要解決的另...
第6章光刻工藝 6.1光致抗蝕劑 6.2光學光刻工藝原理 6.2.1氣相成底膜 6.2.2塗膠和前烘 6.2.3對準和曝光 6.2.4顯影和堅膜 6.3其他曝光技術簡介 6.4質量控制 6.5小結 參考視頻 第7章刻蝕工藝 7.1刻蝕參數 7.1.1...
其中材料部分包括了矽、薄膜材料及其製備工藝和結構,基本工藝部分包括了薄膜製備、外延、光刻、刻蝕、熱氧化、擴散、離子注入、化學機械拋光(CMOS)、鍵合、澆鑄和衝壓等;結構部分包括了自對準結構、電漿刻蝕結構、濕法刻蝕的矽結構、...
