FinFET全稱Fin Field-Effect Transistor,中文名叫鰭式場效應電晶體,是一種新的互補式金氧半導體電晶體。FinFET命名根據電晶體的形狀與魚鰭的相似性。其電子顯微鏡照片如左圖所示。
FinFET源自於傳統標準的電晶體—場效應電晶體(Field-Effect Transistor,FET)的一項創新設計。在傳統電晶體結構中,控制電流通過的閘門,只能在閘門的一側控制電路的接通與斷開,屬於平面的架構。在FinFET的架構中,閘門成類似魚鰭的叉狀3D架構,可於電路的兩側控制電路的接通與斷開。 這種設計可以大幅改善電路控制並減少漏電流(leakage),也可以大幅縮短電晶體的柵長。
基本介紹
- 中文名:鰭式場效應電晶體
- 外文名:Fin Field-Effect Transistor
- 類別:互補式金屬氧化物半導體電晶體
- 發明人:胡正明教授
- 優勢:大幅改善電路控制並減少漏電流,大幅縮短電晶體的柵長
- 套用:等CMOS器件
工作原理,結構,技術發展狀況,套用,優勢,
工作原理
FinFEt被稱為鰭式場效應電晶體,是一種新的互補式金屬氧化物半導體電晶體。該項技術的發明人是加州大學伯克利分校的胡正明教授。
如右圖所示,FinFet與平面型MOSFET結構的主要區別在於其溝道由絕緣襯底上凸起的高而薄的鰭構成,源漏兩極分別在其兩端,三柵極緊貼其側壁和頂部,用於輔助電流控制,這種鰭形結構增大了柵圍繞溝道的面,加強了柵對溝道的控制,從而可以有效緩解平面器件中出現的短溝道效應,大幅改善電路控制並減少漏電流,也可以大幅縮短電晶體的柵長,也正由於該特性,Finfet無須高摻雜溝道,因此能夠有效降低雜質離子散射效應,提高溝道載流子遷移率。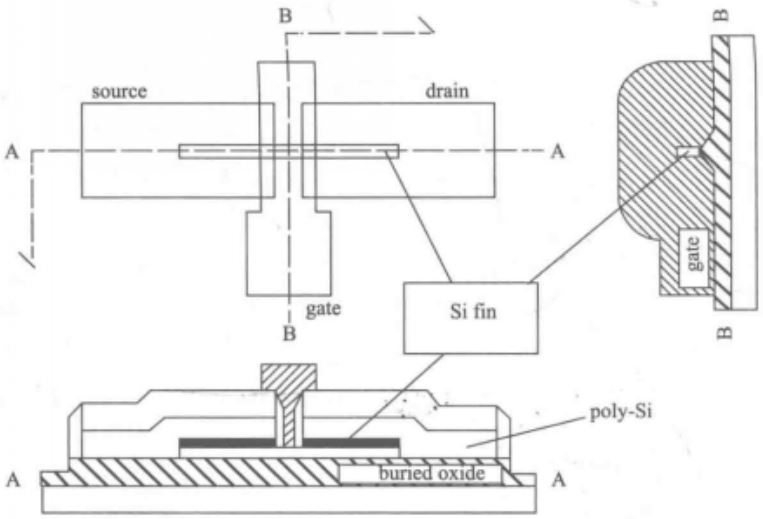 FinFEt工作原理圖
FinFEt工作原理圖
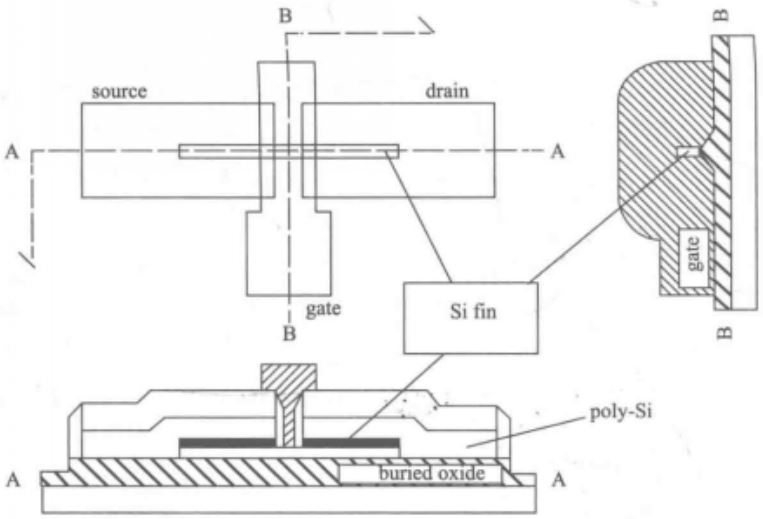 FinFEt工作原理圖
FinFEt工作原理圖結構
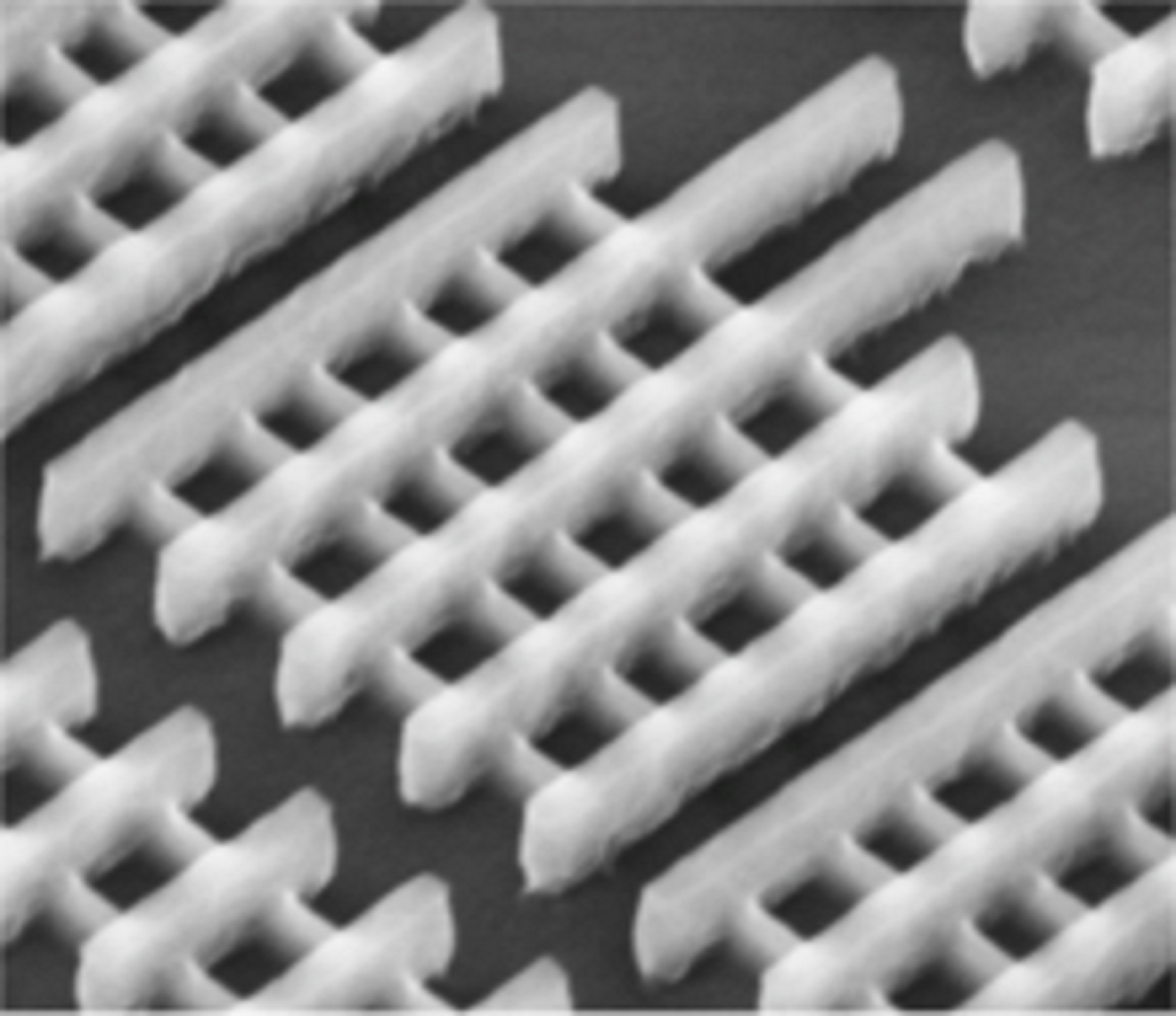 圖1 英特爾公布的FinFET的電子顯微鏡照片
圖1 英特爾公布的FinFET的電子顯微鏡照片如右圖所示,FinFET的主要特點是,溝道區域是一個被柵極包裹的鰭狀半導體。沿源漏方向的鰭的長度,為溝道長度。柵極包裹的結構增強了柵的控制能力, 對溝道提供了更好的電學控制,從而降低了漏電流,抑制短溝道效應。然而FinFET有很多種,不同的FinFET有不同的電學特性。下面根據襯底類型、溝道的方向、柵的數量、柵的結構,分別給予介紹。SOI FinFET 和體FinFET。根據FinFET襯底,FinFET可以分成兩種。一種是SOI FinFET,一種是體FinFET。體FinFET形成在體矽襯底上。由於製作的工藝不同,相比於SOI襯底,體矽襯底具有低缺陷密度,低成本的優點。此外,由於SOI襯底中埋氧層的熱傳導率較低,體矽襯底的散熱性能也要優於SOI襯底。
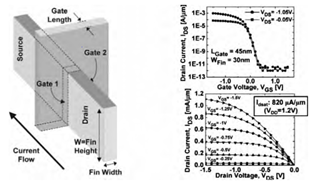 圖2 FinFET的結構和I - V參數
圖2 FinFET的結構和I - V參數體FinFET,SOI FinFET具有近似的寄生電阻、寄生電容,從而在電路水平上可以提供相似的功率性能。但是 SOI 襯底的輕鰭摻雜FinFET,相比於體FinFET,表現出較低的節電容,更高的遷移率和電壓增益的電學性能。
這種結構的特點有以下幾點:
- 用來抑制短溝道效應的超薄Si鰭;
- 兩個柵極是自對準的,同時和源漏也是對準的;
- 在源漏區生長多晶矽,可以減少寄生電阻;
- 短的(50nm)Si鰭是一個準平面結構;
- 柵極後製作工藝,和低溫、高K柵介質相相容。
技術發展狀況
在2011年初,英特爾推出了商業化的 FinFEt,使用在其22m節點的工藝上。台積電等主要半導體代工企業也已經開始計畫推出自己的 FinFEt。從2012年起, FinFet已經開始向20mm節點和14nm節點推進。
未來的發展重點:在鍺矽中實施P型摻雜以改善器件性能,最佳化鍺上矽鈍化層厚度,改善溝道柵纏繞效應。該項研究驗證了採用鰭式場效應電晶體結構的鍺―鍺矽異構量子阱器件,不僅能提供應變能力,而且能增強溝道控制力。
採用鰭替代工藝實現了將II-V族材料套用於CMOS器件結構中。這一研究成果使此次將鍺通過鰭替代工藝構成CMOS器件的溝道成為可能。這是實現單片異質集成,發展CMOS器件和片上系統的關鍵技術。
比利時微電子研究中心的下一代鰭式場效應電晶體研究是其核心CMOS項目的一部分。
套用
具有實用性的應變鍺量子阱溝道P型金屬氧化物半導體(MoS)鰭式場效應電晶體表明,鰭式場效應電晶體和三柵結構具備套用於7mm和5nm CMos器件的可能性。
自CMOS器件發展到90m技術以來,在器件中嵌入鍺矽源極和漏極已經是一種產生應變矽增強P型MOS器件的普遍方法。器件尺寸的減少,使源極和漏極中實現應變的空間極為有限。採用薄型結構的鰭式場效應電晶體已經難以進一步微細化。將高應變材料直接套用於溝道將是CMOS器件繼續微細化的可行途徑。
比利時微電子研究中心在弛豫的鍺矽緩衝層上生長出高應變鍺溝道,已證明這種方法能夠提高溝道電子遷移率,具有良好的按比例縮小溝道尺寸潛力。採用鰭式替代工藝製造應變鍺溝道器件,對於在常規矽襯底上實現與其他器件的集成非常有用。建立在鍺矽溝道緩衝層上的應變鍺P溝道鰭式場效應電晶體的跨導峰值,在0.5V源漏電壓下為1.3ms/μm,具有低至60mm柵長的良好短溝道控制能力。該器件亞閾值斜率跨導高於已宣布的弛豫鍺鰭式場效應電晶體。
優勢
FinFET器件相比傳統的平面電晶體來說有明顯優勢。首先,FinFet溝道一般是輕摻雜甚至不摻雜的,它避免了離散的摻雜原子的散射作用,同重摻雜的平面器件相比,載流子遷移率將會大大提高。另外,與傳統的平面CMOS相比,FinFET器件在抑制亞閾值電流和柵極漏電流方面有著絕對的優勢。FinFET的雙柵或半環柵等體鰭形結構增加了柵極對溝道的控制面積,使得柵控能力大大增強,從而可以有效抑制短溝效應,減小亞閾值漏電流。由於短溝效應的抑制和柵控能力的增強,finFET器件可以使用比傳統更厚的柵氧化物,這樣FinFET器件的柵漏電流也會減小。顯然,FinFET優於PDSOI。並且,由於FinFET在工藝上與CMOS技術相似,技術上比較容易實現。 所以已被很多大公司用在小尺寸IC的製造中。