《製作砷化銦/磷化銦量子點雷射器有源區的方法》是中國科學院半導體研究所於2012年5月15日申請的發明專利,該專利申請號為201210150154X,公布號為CN102684070A,公布日為2012年9月19日,發明人是羅帥、季海銘、楊濤。
一種製作砷化銦/磷化銦量子點雷射器有源區的方法,包括如下步驟:步驟1:選擇一磷化銦襯底;步驟2:在該磷化銦襯底上外延生長一層磷化銦緩衝層;步驟3:在磷化銦緩衝層上沉積晶格匹配的銦鎵砷磷薄層;步驟4:在銦鎵砷磷薄層上外延生長多周期的砷化銦量子點有源層;步驟5:在砷化銦量子點有源層上沉積銦鎵砷磷蓋層,完成量子點雷射器有源區的製備。該發明是在砷化銦/磷化銦量子點生長停頓間隙,通過改變五族保護源流量來抑制As/P互換效應,調控量子點形貌,結合兩步生長蓋層技術,達到既保持良好光學性能又能調諧發光波長的目的。這種方法可以實現InAs/InP量子點發光波從1.3-1.7微米寬達400納米的範圍內可控調節。
2021年6月24日,《製作砷化銦/磷化銦量子點雷射器有源區的方法》獲得第二十二屆中國專利優秀獎。
(概述圖為《製作砷化銦/磷化銦量子點雷射器有源區的方法》摘要附圖)
基本介紹
- 中文名:製作砷化銦/磷化銦量子點雷射器有源區的方法
- 申請人:中國科學院半導體研究所
- 發明人:羅帥、季海銘、楊濤
- 申請號:201210150154X
- 申請日:2012年5月15日
- 公布號:CN102684070A
- 公布日:2012年9月19日
- 地址:北京市海淀區清華東路甲35號
- 代理機構:中科專利商標代理有限責任公司
- 代理人:湯保平
- Int. Cl.:H01S5/343
- 類別:發明專利
專利背景,發明內容,專利目的,技術方案,附圖說明,技術領域,權利要求,實施方式,專利榮譽,
專利背景
截至2012年5月,新一代高速光通信系統迫切需要低功耗、高性能長波長半導體雷射光源。作為傳送信號載體光波的發射源或光源的重要候選,半導體量子點雷射器因其諸多優勢受到了科學家們的極大關注。量子點具有三維限制載流子運動的能力,會產生類似原子的分裂能級,從而產生了很多獨特的光電性質。半導體量子點雷射器相比於一維受限的量子阱雷射器具有更好的溫度穩定性,更低的閾值電流密度、更高的微分增益、更小的頻率啁啾效應等優越性能。
基於砷化鎵(GaAs)基的In(Ga)As量子點已被廣泛深入研究。但由於InAs與GaAs材料晶格失配較大(7.1%),InAs/GaAs量子點材料主要發光在1-1.3微米範圍,儘管人們做了很多嘗試試圖拉長該體系量子點發光波長,作為光通訊套用的C波段(1530-1561納米)範圍仍難以達到。因此,為了獲得高性能1.55微米長波長量子點光源,人們將目光轉向晶格失配較小(3.2%)的InAs/InP量子點材料系統。
由於InAs與InP的晶格失配小,採用應變自組織方式(SK)生長的InAs量子點相比於GaAs基上量子點尺寸較大。生長的InP基InAs量子點發光波長一般在1.6-1.9微米範圍,超出了光通訊套用所需波長範圍。為滿足需要,人們迫切需要探索將InAs/InP波長調至1.55微米波段的技術。
同時,由於在InP上生長InAs量子點具有As/P互換效應從而向量子點中引入了額外InAs沉積量,進一步增大了量子點的體積,加大了InAs/InP量子點的發光波長。產生的大量子點引入缺陷降低量子點的發光效率。文獻報導的調節波長的技術主要是通過向量子點下插入GaAs薄層或者向量子點中摻入Ga組分來調節波長,但結果都極大的降低量子點的發光效率以及增大量子點發光光譜的半高寬,從而降低了量子點雷射器的光學性能。為了能獲得較好光學性能且波長精確可控的InAs/InP量子點,提出一種製作砷化銦/磷化銦量子點雷射器有源區的方法,通過控制生長停頓間隙V族源保護有效調節砷化銦/磷化銦量子點材料發光波長。通過精確控制生長停頓間隙V族源保護,在寬達400納米範圍實現波長調諧,同時削減發光光譜半高寬,保證量子點具有良好可控的光學性能。
發明內容
專利目的
《製作砷化銦/磷化銦量子點雷射器有源區的方法》的目的在於提供一種製作砷化銦/磷化銦量子點雷射器有源區的方法,其是在砷化銦/磷化銦量子點生長停頓間隙,通過改變五族保護源流量來抑制As/P互換效應,調控量子點形貌,結合兩步生長蓋層技術,達到既保持良好光學性能又能調諧發光波長的目的。這種方法可以實現InAs/InP量子點發光波從1.3-1.7微米寬達400納米的範圍內可控調節。
技術方案
《製作砷化銦/磷化銦量子點雷射器有源區的方法》提供一種製作砷化銦/磷化銦量子點雷射器有源區的方法,包括如下步驟:
步驟1:選擇一磷化銦襯底;
步驟2:在該磷化銦襯底上外延生長一層磷化銦緩衝層;
步驟3:在磷化銦緩衝層上沉積晶格匹配的銦鎵砷磷薄層;
步驟4:在銦鎵砷磷薄層上外延生長多周期的砷化銦量子點有源層;
步驟5:在砷化銦量子點有源層上沉積銦鎵砷磷蓋層,完成量子點雷射器有源區的製備。
附圖說明
圖1是外延結構示意圖;

圖1
圖2是隨生長停頓間隙V族保護源變化而改變的InAs/InP量子點有源區光致發光譜(PL)。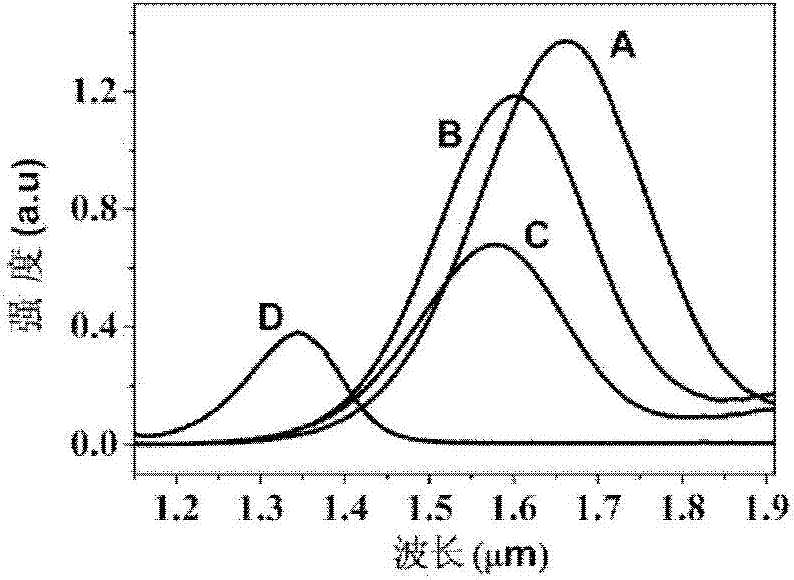
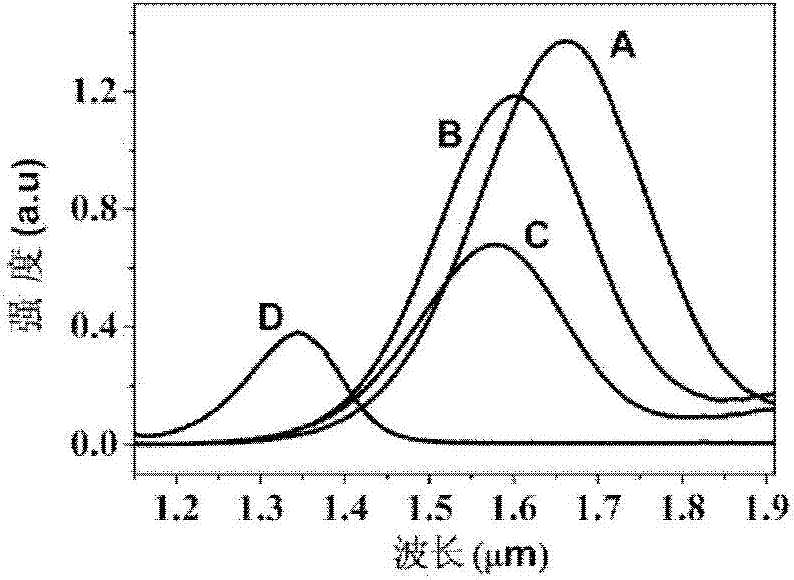
圖2
技術領域
《製作砷化銦/磷化銦量子點雷射器有源區的方法》屬於半導體技術領域,特別是指一種製作砷化銦/磷化銦量子點雷射器有源區的方法,該方法基於低維半導體納米結構量子點材料的量子器件,如砷化(鎵)銦/磷化銦(In(Ga)As/InP)量子點雷射器有源區的外延生長方法。具體地涉及通過控制生長停頓期間V族保護源調節砷化銦/磷化銦量子點材料發光波長。
權利要求
1.一種製作砷化鋼/磷化銦量子點雷射器有源區的方法,包括如下步驟:步驟1:選擇一磷化銦襯底;步驟2:在該磷化銦襯底上外延生長一層磷化銦緩衝層;步驟3:在磷化銦緩衝層上沉積晶格匹配的銦鎵砷磷薄層;步驟4:在銦鎵砷磷薄層上外延生長多周期的砷化銦量子點有源層,該多周期的砷化銦量子點有源層的每一周期包括一量子點層,第一蓋層,第二蓋層;沉積完砷化銦量子點層,關閉銦源,生長停頓期間通過降低砷保護氣氛流量或者交替開和關砷源,起到調節量子點發光波長的作用,在量子點上生長第一蓋層,在第一蓋層上生長第二蓋層,其中生長停頓時間在120秒以內,砷保護氣氛的摩爾流量在0-1標準毫升/分鐘之間變化;步驟5:在砷化銦量子點有源層上沉積銦鎵砷磷蓋層,完成量子點雷射器有源區的製備。
2.根據權利要求1所述的製作砷化銦/磷化銦量子點雷射器有源區的方法,其中多周期的砷化銦量子點有源層的周期數為1-20。
3.根據權利要求1所述的製作砷化銦/磷化銦量子點雷射器有源區的方法,其中第一蓋層的生長溫度介於430至560攝氏度之間,澱積厚度介於1到20納米之間,該第二蓋層的生長溫度高於第一蓋層的生長溫度,該砷化銦量子點有源層的厚度小於60納米。
4.根據權利要求1所述的製作砷化銦/磷化銦量子點雷射器有源區的方法,其中磷化銦緩衝層的生長溫度介於550攝氏度至650攝氏度之間;V族與III族源摩爾比大於50。
5.根據權利要求1所述的製作砷化銦/磷化銦量子點雷射器有源區的方法,其中銦鎵砷磷薄層的生長溫度介於550攝氏度至650攝氏度之間;澱積厚度小於300納米。
6.根據權利要求1所述的製作砷化銦/磷化銦量子點雷射器有源區的方法,其中量子點層的生長溫度介於430至560攝氏度之間;沉積厚度介於1至5個原子單層。
7.根據權利要求1所述的製作砷化銦/磷化銦量子點雷射器有源區的方法,其中外延生長包括分子束外延法和金屬有機化學沉積法。
實施方式
《製作砷化銦/磷化銦量子點雷射器有源區的方法》提供一種製作砷化銦/磷化銦量子點雷射器有源區的方法,包括如下步驟:
步驟1:選擇一磷化銦襯底10,該襯底為n+型InP單晶片,晶向為(100),厚度為325-375微米,摻雜濃度為(1-3)×10厘米。
步驟2:在該磷化銦襯底10上外延生長一層磷化銦緩衝層11,該磷化銦緩衝層11的生長溫度為645攝氏度,厚度為300納米,V族與III族源摩爾比為200。
步驟3:在磷化銦緩衝層11上沉積晶格匹配的銦鎵砷磷薄層12,該銦鎵砷磷薄層12的生長溫度為645攝氏度;澱積厚度100納米;其生長速度為0.5納米/秒,V族源As、P與III族源Ga、In的摩爾流量(V/III)為150。在生長雷射器結構時,本層作為雷射器的下限制波導層。
步驟4:在銦鎵砷磷薄層12上外延生長多周期的砷化銦量子點有源層13,該多周期的砷化銦量子點有源層13的周期數為1-20,所述多周期的砷化銦量子點有源層13的每一周期包括一層量子點層131,第一蓋層132,第二蓋層133。其量子點層131生長溫度為480攝氏度,沉積厚度為2毫升,沉積速度為0.33毫升/秒,V/III為4.1。沉積完砷化銦量子點層131,關閉In源,生長停頓期間通過降低As保護流量或者交替開和關砷源,起到調節量子點發光波長的作用。降低As保護一方面有助於抑制In原子在生長表面上的遷移,減小量子點的尺寸,從而達到調節波長的目的;另一方面,As保護流量的降低抑制了基底InGaAsP中In原子因As/P互換效應向量子點中的遷移,阻止量子點尺寸以及尺寸分布的進一步加大。所述生長停頓時間為5秒,As保護氣氛的摩爾流量在0-1標準毫升/分鐘之間變化;過長的生長停頓時間會促進大量子點的形成,從而使雷射器有源區發光波長紅移。生長停頓結束後,在量子點層131上生長第一蓋層132,在第一蓋層132上生長第二蓋層133。所述第一蓋層132的生長溫度與量子點生長溫度相同,其中V/III比為250,厚度為10納米。沉積完InGaAsP第一蓋層131後,關閉所有III族源及V族砷源,只採用PH3保護第一蓋層132表面。其保護流量為30標準毫升/分鐘。所述第二蓋層133厚度為30納米,生長溫度為510攝氏度,較高的生長溫度有助於獲得高質量的四元系InGaAsP材料,減少因溫度過低,生長源不完全分解導致的缺陷引入,從而提高整體器件的工作效率。但過高的第二蓋層133生長溫度,在生長疊層量子點結構時較大幅度的反覆升降溫會引起量子點反覆退火,不利於獲得高質量的量子點雷射器有源區材料。以上所述量子點層131,第一蓋層132,第二蓋層133三部分構成一完整周期量子點有緣層13。多層結構量子點構成的有源區重複該步驟4生長。
步驟5:在砷化銦量子點有源層13上沉積銦鎵砷磷蓋層14,完成量子點雷射器有源區的製備。所述銦鎵砷磷蓋層14生長速度為0.5納米/秒,生長溫度為645攝氏度,其厚度為100納米。在生長雷射器結構時,本層作為雷射器的上限制波導層。
以上所述外延生長採用金屬有機化學沉積法,外延生長使用的源分別是三甲基銦(TMIn),三乙基鎵(TEGa),砷烷(AsH3),磷烷(PH3)。
圖2為控制生長停頓V族保護源的InAs/InP量子點有源區光致發光譜(PL)。PL峰位隨停頓間隙AsH3流量的減少而藍移。圖中所有樣品停頓時間均為5秒。其中樣品A為5秒採用AsH3持續保護,流量為1標準毫升/分鐘;樣品B為5秒內AsH3持續保護,流量降低為0.5標準毫升/分鐘;樣品C採用間斷保護,前3秒切斷AsH3保護,然後再打開AsH3時間2秒,打開流量為1標準毫升/分鐘;樣品D為完全關閉AsH3,沒有AsH3保護。從A、B、C、D樣品PL結果可以看出,樣品峰位隨著AsH3保護流量的減少持續藍移,調節範圍從1.66微米到1.34微米寬達320納米範圍之間連續變化;且PL譜半高全寬(FWHM)從107.8兆電子伏(240納米)減小到91兆電子伏(130納米)。從而我們可以通過控制生長停頓間隙V族保護源來有效調節InAs/InP量子點發光波長使其覆蓋全部通訊波段(1.3和1.55微米波段)。依此方法為基礎,生長疊層結構量子點作為半導體量子點雷射器的有源區可以保證雷射器件具有良好波長可控性和優越的器件性能。
專利榮譽
2021年6月24日,《製作砷化銦/磷化銦量子點雷射器有源區的方法》獲得第二十二屆中國專利優秀獎。