基本介紹
- 中文名:光刻膠模型校準
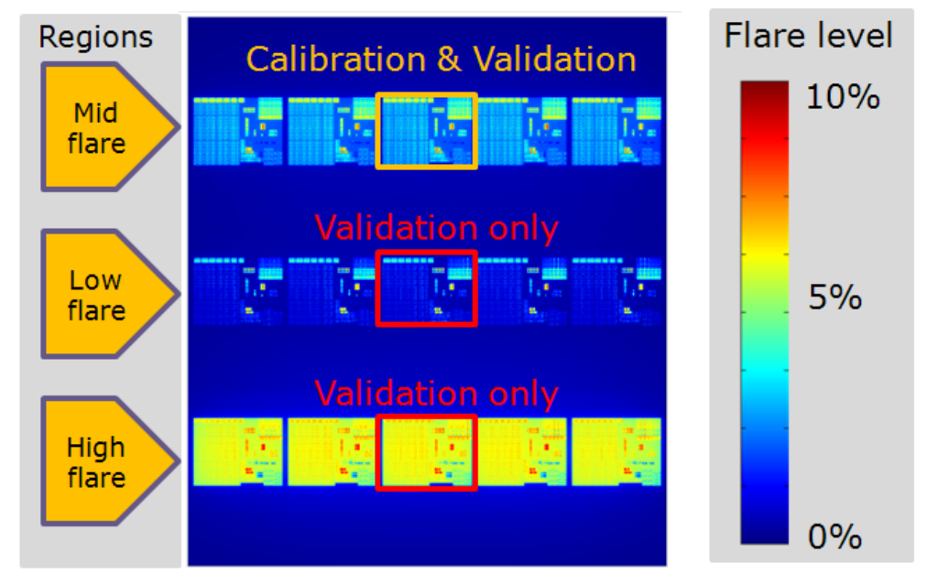

具體流程
實驗條件的對標
光刻膠形貌的測量
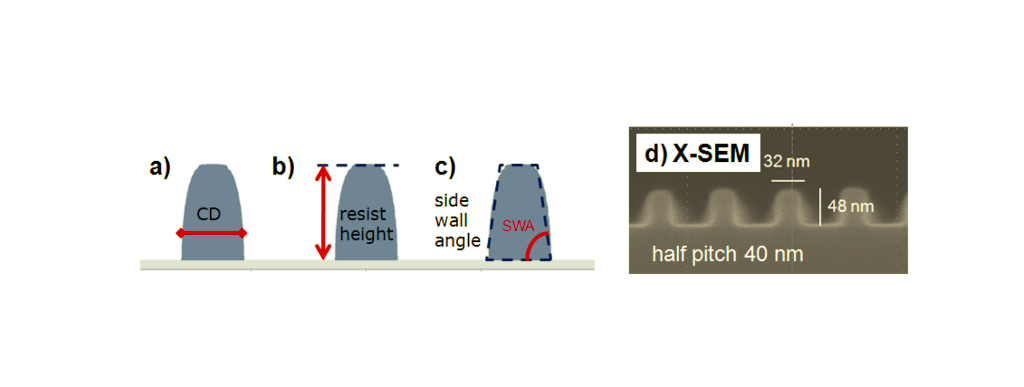
模型校準
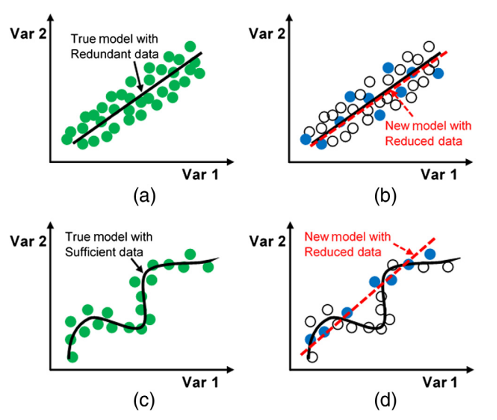
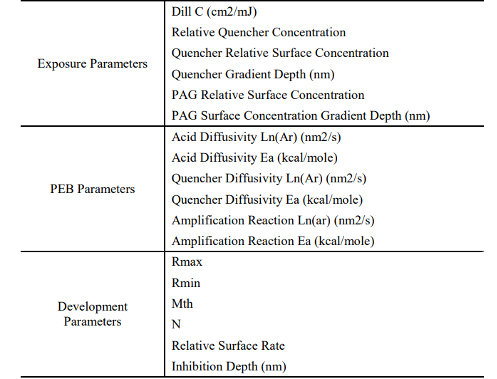

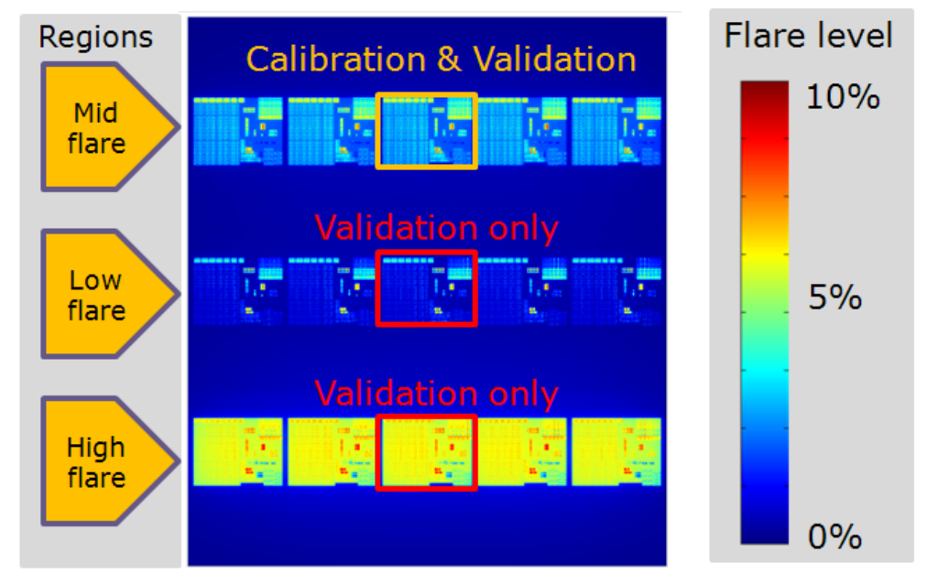

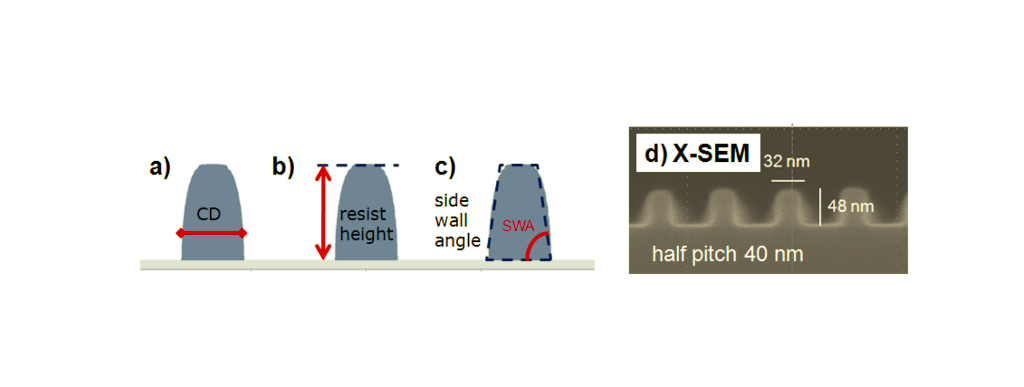
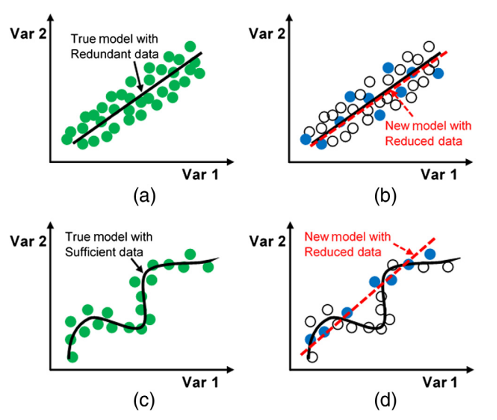
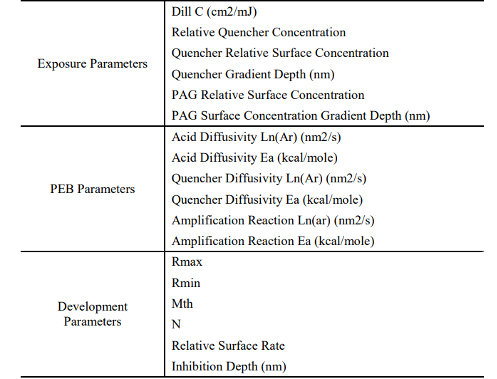
光刻模型包含光學模型和光刻膠模型,其中光刻膠模型描述了光刻膠曝光顯影過程中發生的物理化學反應。光刻膠模型可以為光刻膠的研發和光刻工藝的最佳化提供指導。然而,由於模型中許多參數不可直接測量或測量較為困難,通常採用實際曝光結果...
常見有顯影模型為Mack模型。具體分為三步:第一步,顯影液中的有效成分(TMAH分子)擴散到光刻膠所在的位置;第二步,TMAH分子與光刻膠發生化學反應;第三步,反應的生成物溶解於顯影液中,並在顯影液中擴散。發展方向 (1) 建立更準確的針對化學放大膠的模型 (2) 建立浸沒式光刻中水與光刻膠相互作用的模型...
11.13.1不同光瞳照明條件對掩模版圖形的影響 11.13.2一個交叉互聯圖形的光源掩模聯合最佳化舉例 11.14光刻膠曝光顯影模型 11.14.1一般光刻膠光化學反應的閾值模型 11.14.2改進型整合參數模型 11.14.3光刻膠光酸等效擴散長度在不同技術節點上的列表 11.14.4負顯影光刻膠的模型特點 11.14.5負顯影光刻...
基於模型的光學鄰近效應修正從90nm技術節點開始被廣泛套用。它使用光學模型和光刻膠化學反應模型來計算出曝光後的圖形。該方法的關鍵是建立精確的光刻模型,包括光學模型和光刻膠模型,為達到較高的計算速度,這些模型都採用近似模型,其中包含一系列參數,需要實驗數據來進行擬合,以保證模型的精確度。顯然實驗數據越多...
表示光掩膜的關鍵尺寸值,p代表節距。“-”和 “+”分別表示線的結果或者空隙的結果。令方程等於MEF的量測值,可以計算出有效的光刻膠擴散長度。該結果可套用到光學臨近效應修正的模型校準之中。高斯等效擴散模型 用來描述光酸擴散的物理模型,也是目前計算光學中最常用的用來模擬預測光刻膠曝光後形貌的模型之一。該...
